到目前为止,所有的IGBT设计都有一个共同点平面栅极结构。这种形状的栅极形成一个前文所述的JFET结构,以及发射极区软弱的电导调制效应。对于平面栅极的IGBT,载流子的浓度从集电极到发射极之间逐步降低。新一代IGBT的设计目标是保持载流子浓度均匀分布,最好是逐步增加,这样可以进一步降低通态损耗,而不会影响拖尾电流和关断损耗,从而导致沟槽型栅极结构的出现。
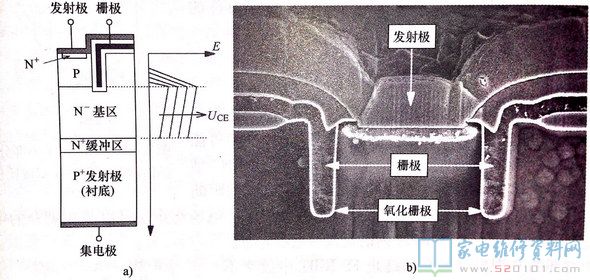
图1 沟槽栅IGBT内部结构和电场分布(不成比例)及栅极结构
上图1a给出了基于PT IGBT原理的沟槽栅IGBT内部结构和电场分布图,而图1b是通过电子扫描显微镜拍摄的沟槽栅极结构的放大图。这种结构与普通的平面栅极结构的主要区别在于,当IGBT开通时,P型发射区的反型沟道是垂直的而不是横向的,这就意味着不存在JFET效应。由于大量电子的注入,发射区附近的电导调制效率很高。
所有这些都对载流子的浓度产生积极影响。作为比较,图2给出了沟槽栅和平面栅结构IGBT内部载流子浓度比较。非常明显,从集电极到发射极,沟槽栅IGBT的载流子浓度是逐步升高的,而平面IGBT则相反。发射区载流子浓度的设计与很多因素相关,其中包括IGBT元胞的尺寸和他们之间的距离,这样就使得载流子浓度的调整有无限多的可能。然而应该牢记的是,更高的载流子浓度有利于降低通态损耗;另一方面,载流子越少,越有利于降低关断损耗。事实证明,内部均匀的或者略微递增的载流子浓度有利于平衡沟槽栅IGBT的静态和动态损耗。
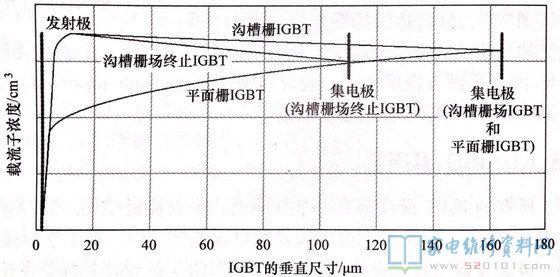
图2 沟槽栅和平面栅结构IGBT内部载流子浓度比较
根据图3所示的简化电路图,IGBT内部的电压降可表示为:
UCEsat=UEmitter-Drain+UDrain-Collector
UEmitter-Drain表示IGBT的发射极和等效MOSFET漏极的电压,UDrain-Collector表示漏极到集电极之间的电压。可以通过增加每个IGBT导电沟道的宽度来降低UEmitter-Drain。相比于平面栅IGBT,沟槽栅IGBT垂直结构的导电沟道更有利于设计紧凑的元胞。即在同等芯片面积上可以制作更多的IGBT元胞,从而增加导电沟道的宽度。另外,UEmitter-Drain可以通过消除JFET效应的方法进一步降低。采取这些方法,可以消除UCEsat中UEmitter-Drain分量。也就是说,对于现代的IGBT,饱和压降主要由UDrain-Collector决定。

图3 IGBT简化等效电路
增加导电沟道的宽度有利于电导率上升,但是也有它的缺点:较宽的导电沟道会增加IGBT短路时的电流。最不利的情况就是,短路电流可能会很大,以至于非常短时间内就损坏IGBT。为了使得IGBT具有10μs的短路能力(给定的测试条件下),需要非常小心地设计沟道宽度及相邻的元胞。为此需要平衡元胞的尺寸和间距,或者不要把所有的栅极接到公共栅极,而是把一些单元的栅极和发射极直接短路。后者称为插入合并单元工艺(Plugged Cell Merged,PCM)。平面栅IGBT和沟槽栅IGBT结构如图4所示。

图4 平面栅IGBT和沟槽栅IGBT结构
网友评论